涂镀层厚度测量仪X-RAY XDV-µSEMI
型号:SEMI
FISCHERSCOPE X-RAY XDV-μ SEMI 是一款全自动测量系统。针对半导体行业复杂的 2.5D/3D 封装应用中的微结构质量控制进行了优化。全自动分析可避免损坏宝贵的晶圆材料。此外,统一的测试条件能够提供可靠的测量结果。该仪器适用于洁净室,完备的配置清单使其能够轻松整合于现有晶圆厂。特性:
全自动晶圆传输与测试流程可提高员工的工作效率
能够针对直径小至 10 µm 的结构进行精确测试
通过图像识别功能自动定位待测位置
通过 FISCHER WinFTM 软件实现简单操作
离线使用:可随时进行手动测量
适用广泛:可适配针对 6"、8" 以及 12" 晶圆的FOUP、SMIF 和 Cassette
应用:
镀层厚度测量
凸点下纳米级厚度的金属化层 (UBM)
铜柱上的无铅焊料凸点(Solder Bump)
极小的接触面以及其他复杂的 2.5D/3D 封装应用
材料分析
C4 以及更小的焊接凸点(Solder Bump)
铜柱上的无铅焊料凸点(Solder Bump)
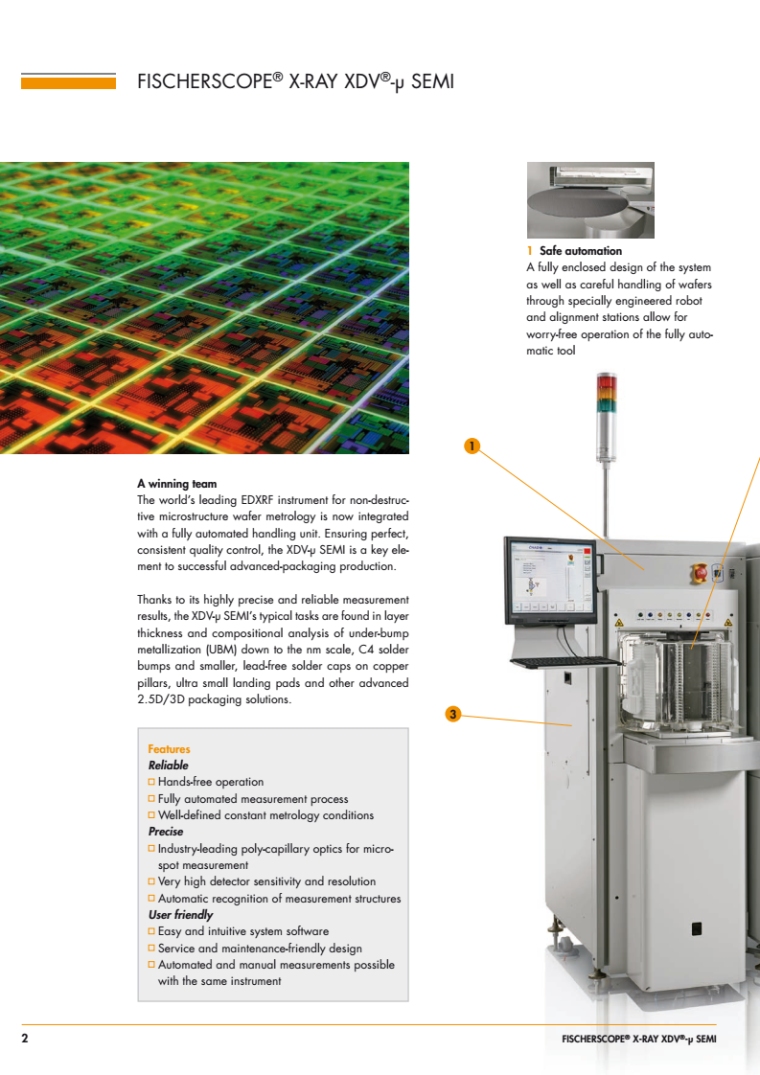
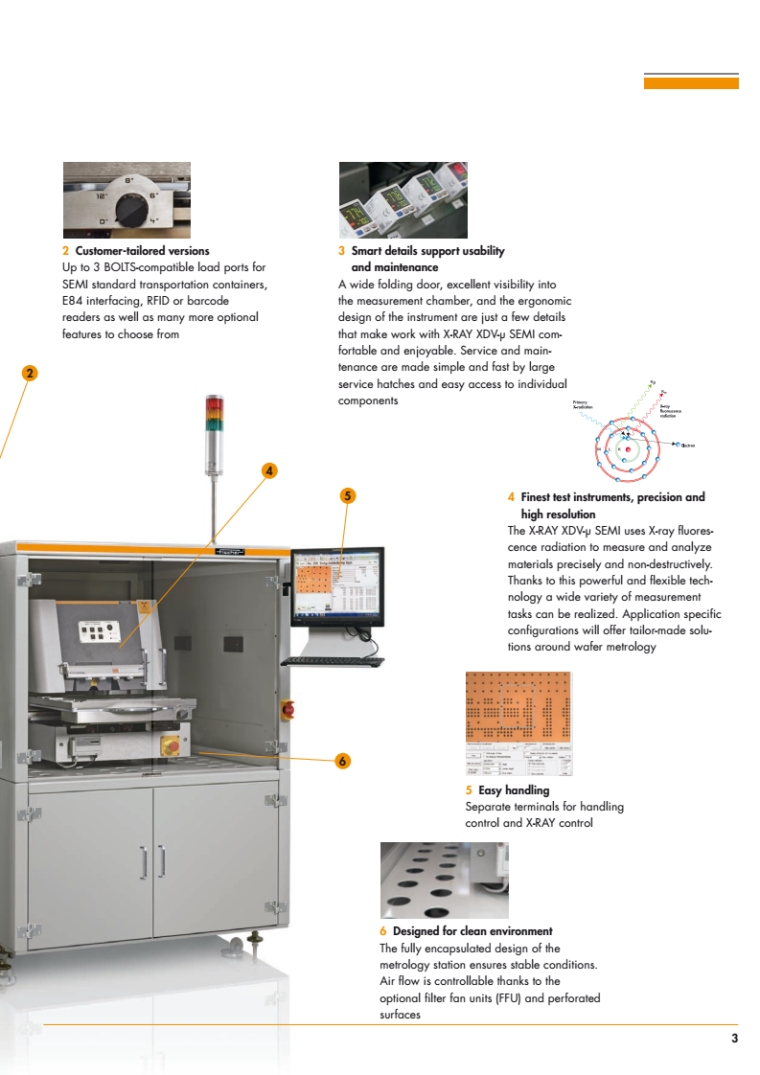
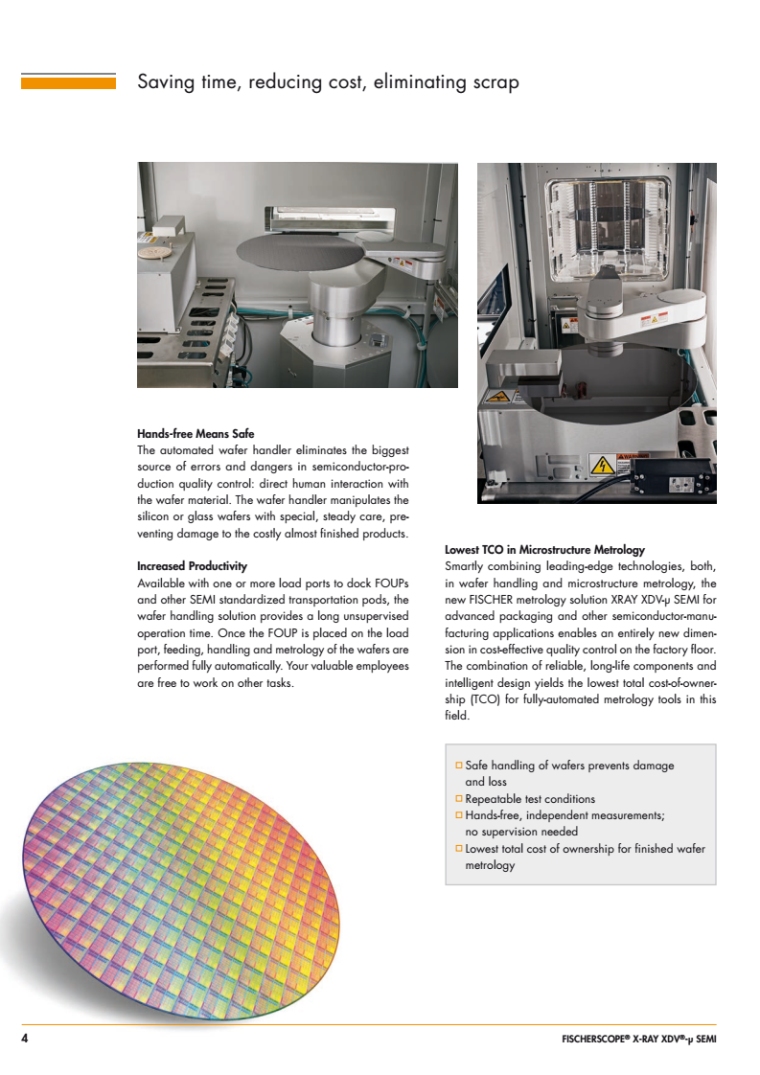
产品发布日期:2026.01.26
菲希尔Fischer测试仪器有限公司

